国内EBL邻近效应修正技术面临的挑战
日期:2025-08-06
EBL凭借电子波长短,不受衍射限制等优势,对比光学光刻具有更高的理论极限分辨率,常被用于掩模版制作和小批量器件研发制作等领域。不过,区别于光学光刻,由于电子束会在抗蚀剂内发生前散射,且还会与衬底材料作用发射背散射,使得电子束作用范围超出原先设定区域,导致图形分辨率下降,尺寸、形貌异常,这一现象也被广大研究人员称为邻近效应。
一、邻近效应的发现及作用原理
高斯束电子束光刻凭借低成本和高分辨率的优势常被用于微纳结构制造[1],早在1975年,T.H.P. Chang就依据实验数据结果,提出了高斯分布函数来描述高斯束系统的EBL曝光时电子作用产生的能量分布,这为邻近效应的提出奠定了理论基础[2]。其实质上由于高能电子束在穿过抗蚀剂层过程中发生的前散射和电子与衬底材料原子的核外电子作用产生的背散射电子所导致的部分电子作用于预设范围外的区域,使得图形线宽异常、边缘分辨率下降的现象[3],其产生原理模拟简图如下图1所示。
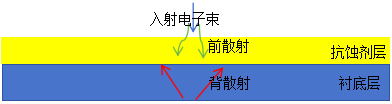
二、邻近效应的修正方法
通常,邻近效应的修正方法包括常用几何尺寸校正和剂量校正[4],以及应用较少的GHOST方法。几何尺寸校正计算通过调整设计图形的形状、尺寸等来改善局部区域内的能量分布,已达到补偿邻近效应带来的影响的作用;而剂量校正法则是以Monte Carlo模型或近似函数拟合模型为主,通过双高斯分布函数:(其中α、β分别代指前散射和背散的高斯分布方差,η为两者的比值)来描述不同区域的电子能量沉积分布,再利用计算机得到α、β和η的具体值,并代入校正软件,进行计算得到不同区域内所需的补偿剂量值,以降低邻近效应带来的副作用。而GHOST方法则是以背散射电子曝光强度的反剂量,利用非聚焦电子束对非曝光区域进行线扫,使整体图形拥有相同的背散射作用剂量,仅考虑了背散射电子的影响,只适合超高加速电压等前提条件下的快捷校正[5]。同时,该方法大多在角度限制散射投影电子束光刻中应用,且图形衬底一般较低[6]。
一般来说,目前主流的优化方式仍然是剂量校正法,通过Monte Carlo模型或近似函数拟合模型,以双高斯分布函数为基础,通过计算机模拟预测电子能量的沉积分布和调整各局部区域曝光剂量的方式,来优化改善图形内的能量分布均匀性[7]。但是该模型的预测模型建立中忽略了二次电子等其它因素的影响,所以仍然只是一个做到大致优化的工具,难以做到全面优化。且各区域补偿参数的设定和计算还受到例如衬底材料均匀性以及进行套刻时的抗蚀剂材料均匀性、抗蚀剂厚度均匀性等的影响,故此,计算出来的补偿数值与实际所需的补偿数值仍然有一定偏差。所以,一种全新的、更精确的模拟模型的出现对于邻近效应校正领域的发展完善而言是迫在眉睫的。
三、邻近效应修正案例
以国内泽攸科技研发人员进行优化测试的一个棋盘图形设计为例,该棋盘单格线宽设计为500nm,原材料利用表面涂覆厚度约100nm的PMMA光刻胶的Si片,使用30kV的加速电压、10μm光阑孔径进行刻写作业,首次刻写时以100μC/cm2至300μC/cm2为限定区间,每增加25μC/cm2剂量为一个组别,不进行邻近效应修正,直接曝光,并显影,利用SEM分析形貌发现边缘与中心区域因电子能量沉积差异,导致其实际图形与设定的棋盘图形存在较大异,其中部分曝光剂量下的形貌图如下图2所示。从下图2中我们可以发现,在175μC/cm2剂量下,靠近最中心区域的图形因为电子能量沉积不足、相邻图形间邻近效应作用小而表现出欠曝现象(黑色部分为残留光刻胶),图形尺寸异常偏小,残留光刻胶过多,而靠近边缘的区域的图形则电子能量沉积较为充足、相邻图形间邻近效应作用较强,使得图形尺寸勉强接近预设尺寸,但是最边缘区域却因周围图形区域太大,电子能量在此区域沉积过大,导致图形尺寸异常偏大。同理,当曝光剂量达到200μC/cm2时,中心区域因能量沉积加大,图形表现接近正常尺寸的图形,靠近边缘区域则因能量沉积过于大而表现出图形尺寸过大现象,而最边缘区域则因能量沉积继续加大,表现出图形尺寸更大,残留光刻胶区域更小的现象。当曝光剂量增加至225μC/cm2时,中心区域也因能量沉积增大,相邻图形间邻近效应作用过强而出现图形尺寸异常偏大,残留光刻胶区域越来越小,至于靠近边缘区域和最边缘区域,则是能量沉积进一步加大,图形尺寸进一步减小。
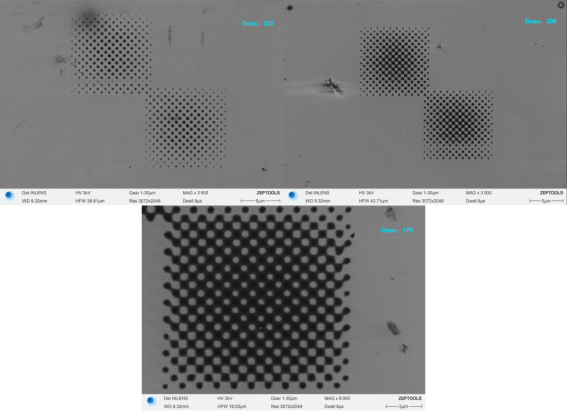
图2 校正剂量前175、200、225μC/cm2条件下SEM形貌图
为优化中心区域图形尺寸不均匀,且与边缘孤立图形差异过大现象,随即开启软件进行邻近效应修正,通过剂量校正使整体能量沉积分布更均匀,该软件同样以Monte Carlo模型为基础,选上对应的衬底材料、光刻胶类型、膜厚等参数后,对整体图形区域进行能量沉积模拟,并分别对欠曝和过曝区域的能量沉积进行调整,将欠曝区域剂量值提升,过曝区域剂量值降低,得到的剂量分布图形如下图3所示,靠近欠曝区域的补偿值提升到了1.25以上,而过曝区域则被降低至约1.15以下。并依据上图2得到的SEM数据表现为依据,对比200μC/cm2和225μC/cm2时的图形表现为几乎整体都能量沉积过大,进行能量沉积校正时必然导致中心能量不足或最边缘区域能量过大,导致图形不均匀,因为该软件调整原理是按照当下剂量为标准,调整中心与边缘不同曝光区域位置的能量沉积比例。故此,判断最佳剂量就应当处于175μC/cm2附近,并再次进行曝光、显影后,在SEM下观察得到部分表现较好组别如下图4所示,其中表现最好的为150μC/cm2剂量的组别,如下图5所示。
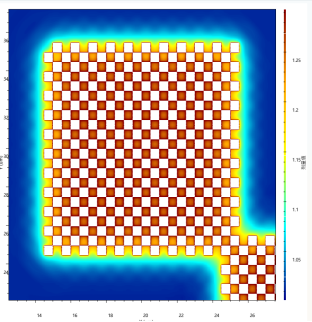
图3 能量沉积模拟示意图
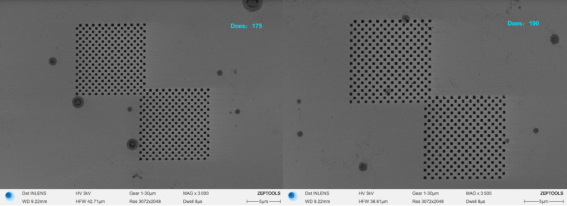
图4 调整后175、190μC/cm2下曝光后SEM数据形貌图
结合上图中175μC/cm2时的表现和图2中未校正前175μC/cm2时的表现,我们可以明显的看到邻近效应对电子束光刻的影响异常显著,修正后图形大多表现为规则的方格形,且中心区域与边缘区域图形尺寸差异不再像调整之前那样巨大,整体上表现明显优于未调整时的状态,邻近效应作用得到显著降低。同样地,190μC/cm2组别的表现也是中心区域图形较为均匀,但中心与边缘图形差异略大。但是,上图中的两个剂量下图形尺寸也仅仅只是靠近中心区域整体表现较为均匀。
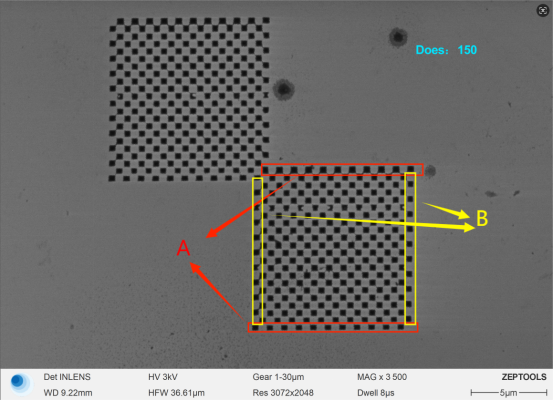
图5 150μC/cm2组别SEM下形貌图
对比图5与图4,我们能发现图5中心区域图形大小一致程度有略微提升,且边缘孤立图形与靠近中心区域的图形尺寸差异也有更明显的缩小,但是靠外侧孤立图形区域在棋盘顶部和底部位置的图形A仍然相比于其它区域尺寸过小明显,而在棋盘两测的孤立图形区域处的图形B,相比于中心区域则有一定的尺寸过大,这也表示在A和B区域的能量沉积仍然存在异常,仍需调整优化。此外,调整后的对应参数也对同类型图形可能有效,图形若有较大变化则效果不明显。故此,可知邻近效应优化技术仍然是电子束光刻关键技术中需要重点攻克的难点之一。
参考文献
[1] 孙伯文,张力,温积森,等. 中国光学十大进展:大尺寸微纳光学器件制造技术(特邀)[J]. 激光与光电子学进展,2025,62(7):1-19. DOI:10.3788/LOP242539.
[2] 陈宝钦,徐秋霞,谢常青,等. 电子束光刻邻近效应校正技术[C]//第十六届全国半导体集成电路硅材料学术会议论文集. 2009:1-15.
[3] 孙霞,尤四方,肖沛,等. 电子束光刻的邻近效应及其模拟[J]. 物理学报,2006,55(1):148-154. DOI:10.3321/j.issn:1000-3290.2006.01.027.
[4] 杨清华,刘明,陈大鹏,等. 高斯电子束曝光系统[J]. 电子工业专用设备,2005,34(2):42-45. DOI:10.3969/j.issn.1004-4507.2005.02.009.
[5] 钱俊. 微纳加工领域新著--《微纳加工及在纳米材料与器件研究中的应用》[J]. 物理,2013(11):821-821.
[6] 肖沛,孙霞,闫继红,等. 电子束光刻中邻近效应校正的几种方法[J]. 电子显微学报,2005,24(5):464-468. DOI:10.3969/j.issn.1000-6281.2005.05.003.
[7] 姚文泽,徐宏成,赵浩杰,等. 电子束光刻"自主可控"EDA软件HNU-EBL[J]. 湖南大学学报(自然科学版),2022,49(10):183-191. DOI:10.6339/j.cnki.hdxbzkb.2022239.
作者:泽攸科技
