从瑞利判据到数字光场:光刻分辨率的极限与工程实践的权衡
日期:2025-12-05
在微纳工程领域,将计算机辅助设计中的数字蓝图转化为具有特定功能的物理器件,依赖于一系列精密的制造工艺,其中光刻技术无疑是定义器件几何构型的基石,然而正如所有物理系统一样,光学光刻的分辨率也受到其内在物理规律的制约。本文将从经典的光学理论出发,探讨影响光刻分辨率的诸元,分析主流的分辨率增强技术,并最终聚焦于无掩模光刻这一新兴范式,是如何在保证精度的前提下,为快速研发和多样化应用提供独特的价值。

理论的边界:瑞利判据及其启示
任何关于光刻分辨率的讨论,都绕不开瑞利判据。

图 瑞利判据:两个相等强度的点光源,其中一个的中央极大值,刚好落在另一个的第一极小值
这个源于天文学家瑞利勋爵用于判断望远镜分辨两颗恒星能力的准则,同样精准地描述了投影式光刻系统所能实现的最小特征尺寸。
CD=k1 * (λ / NA)
这个简洁的公式揭示了决定光刻分辨率三大核心要素:
λ (波长): 曝光光源的波长。更短的波长意味着光波的衍射效应更弱,理论上能够实现更精细的图形。这也是光刻技术发展史上,光源从可见光(g-line 436nm, i-line 365nm)一路演进到深紫外(DUV, 248nm, 193nm),乃至极紫外(EUV, 13.5nm)的根本驱动力。
NA (数值孔径): 投影物镜系统的数值孔径,代表了其收集光线的能力。NA值越大,意味着镜头可以接收更宽角度范围的衍射光,从而保留更多图形的细节信息,提升分辨率。
k1 (工艺因子): 这是一个综合性的工艺相关系数,其值受到光刻胶性能、曝光工艺控制、分辨率增强技术(Resolution Enhancement Techniques, RET)应用等多种因素的影响。k1的理论物理极限为0.25。

图 光刻系统原理图
瑞利判据如同一座灯塔,为光刻技术的演进指明了三个方向:缩短波长(λ)、增大数值孔径(NA)、以及降低工艺因子(k1)。 然而每一条路径的探索都伴随着巨大的技术挑战和成本投入。光源波长的每一次跃迁都意味着整个光学系统、光刻胶材料乃至整个工艺生态的颠覆性变革。而NA值的提升也并非毫无代价,它往往会压缩另一个关键参数——焦深,给工艺控制带来更大挑战。因此在工程实践中,我们更多地是在这三个变量之间寻求一种动态的平衡与优化。
工程的智慧:突破衍射极限的“组合拳”
当特征尺寸不断逼近光源波长时,光的衍射效应愈发显著,单纯依赖缩短波长和增大NA已显得力不从心。为此,一代代光刻工程师们发展出了一系列精巧的“财技”——分辨率增强技术(RET),其核心思想在于通过优化照明方式和掩模版图形,主动地“管理”衍射光场,以期在晶圆表面获得更理想的成像。
浸没式光刻: 这是在增大NA路径上的一大创举。传统光刻机中,投影物镜与晶圆之间是空气(折射率n≈1)。浸没式光刻则在二者间填充了高折射率的液体(如纯水,193nm波长下n≈1.44),等效地将NA的天花板从1.0提升至1.44。这一技术的成功,极大地延长了193nm ArF光刻技术的生命周期,使其能够支撑到45nm甚至更先进的工艺节点。
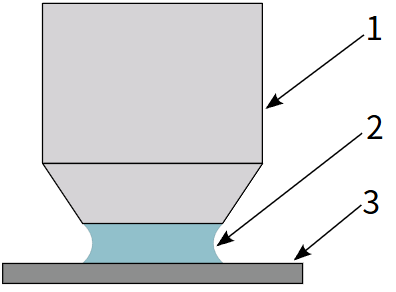
图 在浸没光刻中,来自上方的紫外线辐射先穿过一组透镜(1)和一层薄液膜(2;此处为水),然后照射晶圆(3)表面的光刻胶
离轴照明(OAI): 传统照明方式是光线垂直照射在掩模版上。OAI则通过特殊设计的照明光阑,使光线以一定角度倾斜照射。这种方式可以改变衍射光的空间分布,使得更高频率的衍射级次能够进入物镜,从而增强特定方向(如密集线段)图形的对比度和分辨率。
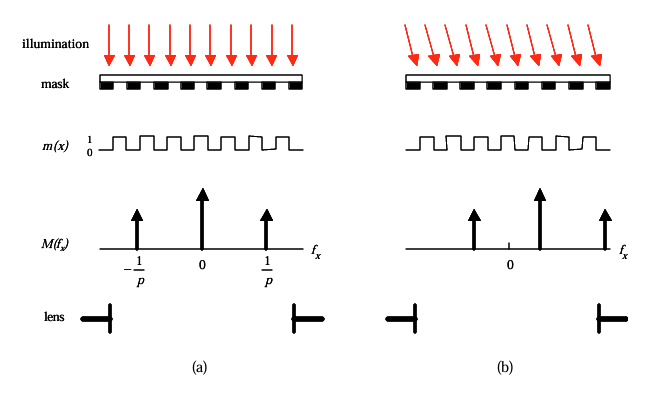
图 离轴照明通过倾斜照明,改变了(a)中所示二元掩模的常规成像,导致(b)中所示的衍射图案发生偏移
相移掩模(PSM): 传统掩模版只控制光的“通”与“断”(振幅)。PSM则在此基础上,通过在特定区域引入厚度变化,额外控制透过光的“相位”。利用光波的干涉相消原理,可以在图形边缘形成更陡峭的光强梯度,从而获得更清晰的成像。
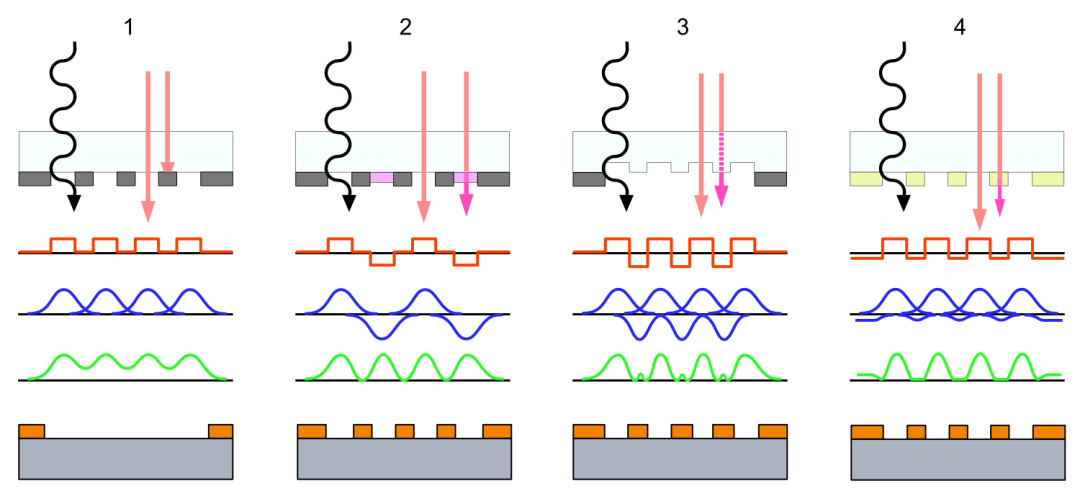
图 相移掩模类型:(1)二元掩模,(2)相移掩模,(3)蚀刻石英掩模(莱文森掩模),(4)半色调掩模。(顶部)掩模,(红色)掩模上的光能/相位,(蓝色)晶圆上的光能/相位,(绿色)晶圆上的光功率,(底部)硅晶圆上的光刻胶
光学邻近效应修正(OPC): 由于衍射效应,掩模版上的矩形在晶圆上可能会成像为圆角或者尺寸失真。OPC技术通过在设计阶段预先对掩模版图形进行“反畸变”处理,例如在尖角处添加辅助图形或调整线条宽度,来补偿成像过程中的光学失真。
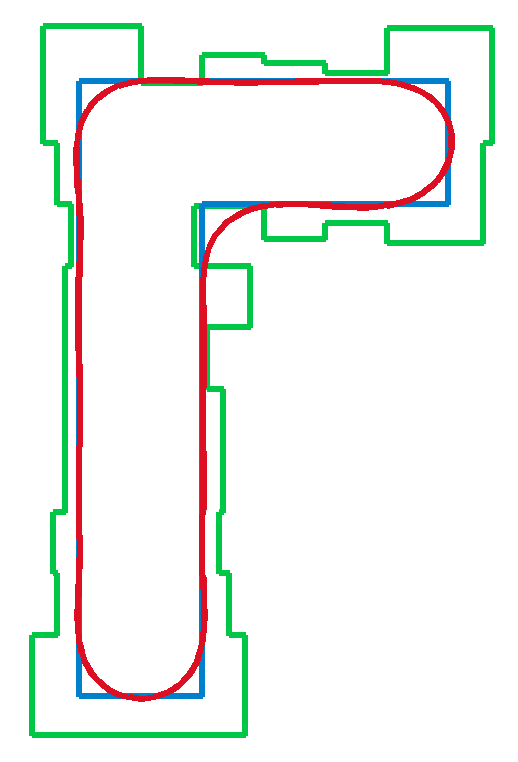
图 一张OPC(光学邻近校正)的示意图。蓝色的Γ形是芯片设计师希望印刷在晶圆上的形状,绿色的是应用光学邻近校正后掩模上的图案,红色的轮廓是该形状实际印刷在晶圆上的样子(与期望的蓝色目标非常接近)
这些RETs技术往往组合使用,形成了极其复杂的计算光刻体系,使得光刻从一门“光学艺术”演变为一门依赖于海量计算和精密建模的“数据科学”。
范式转移:无掩模光刻的灵活性与适用场景
尽管上述RETs技术极大地推动了大规模集成电路制造的进步,但它们高度依赖于一个核心部件——物理掩模版。掩模版的制造不仅成本高昂,且制作周期长,一旦设计有变,整套掩模版便面临作废,这对于研发、原型验证和小批量生产场景而言,无疑是巨大的时间和成本障碍。
正是在这样的背景下,无掩模光刻技术应运而生,它摒弃了物理掩模,转而采用一个可实时编程的“数字掩模”来直接生成曝光图案。目前,基于数字微镜器件(DMD)的无掩模光刻是其中最主流的技术路径之一。
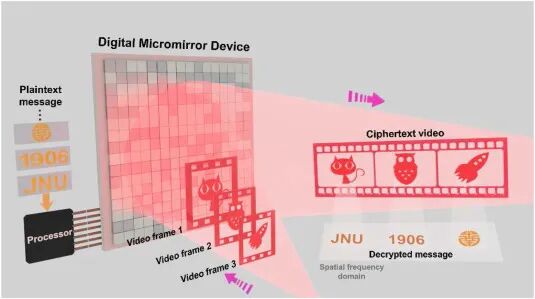
图 DMD图像技术概述
DMD是一种由数百万个微米级的、可独立高速翻转的微型反射镜组成的半导体光开关阵列。通过计算机精确控制每个微镜的偏转角度(“开”或“关”),就可以实时构建出任意的二维光强分布图形,并将其投影到涂有光刻胶的基底上,实现所谓的“直写”。
这一从“物理模板”到“数字光场”的转变,带来了革命性的优势:
极致的灵活性与速度: 设计图案的修改仅需在软件中完成,几分钟内即可实现从设计到曝光的转换,极大地缩短了研发迭代周期。这对于需要频繁进行版图验证的科研工作,以及小批量、多样化的产品试制至关重要。
显著的成本效益: 省去了昂贵的掩模版制作、存储和维护费用,使得小批量生产和个性化定制在经济上成为可能。
强大的功能拓展性: DMD的每个微镜不仅可以实现开/关二值调制,还能通过高速脉冲宽度调制实现多级灰度控制。这一能力使得无掩模光刻可以轻松实现灰度光刻,用于制造具有三维连续形貌的微光学元件(如菲涅尔透镜、微透镜阵列)和复杂的微流控通道等。

图 泽攸科技ZML系列DMD无掩膜光刻机
在这一技术浪潮中,以泽攸科技为代表的科学仪器制造商,通过推出一系列桌面化的DMD无掩模光刻系统,将这一原本局限于特定领域的技术,推广到了更广泛的实验室和研发机构。例如,其ZML系列无掩模光刻机,便体现了该技术在工程应用中的诸多考量。其采用高功率、高均匀度的LED作为曝光光源,结合DMD技术,能够实现亚微米级别的分辨率。同时集成的CCD相机和自动对焦系统,实现了“所见即所得”的引导式曝光与精准套刻,大大降低了操作难度。对于工程师而言,这意味着可以更专注于器件设计与工艺开发,而非耗费大量精力在传统光刻繁琐的掩模对准等步骤上。

图 泽攸科技DMD无掩膜光刻机部分应用案例
在实际应用中,泽攸科技的设备已被用于二维材料器件的电极制备、微流控芯片的快速成型、以及与电子束光刻(EBL)的混合套刻等前沿研究中,充分展现了其在快速原型制造和多功能集成方面的潜力。
在限制与自由之间做出选择
光刻技术的发展史,就是一部不断挑战物理极限,并通过工程创新拓展应用边界的壮丽史诗。从瑞利判据所揭示的理论限制,到浸没式光刻、PSM、OPC等一系列精妙的工程解决方案,再到DMD无掩模光刻所带来的全新设计自由度,我们看到的是一条从“遵循物理”到“驾驭物理”的清晰脉络。
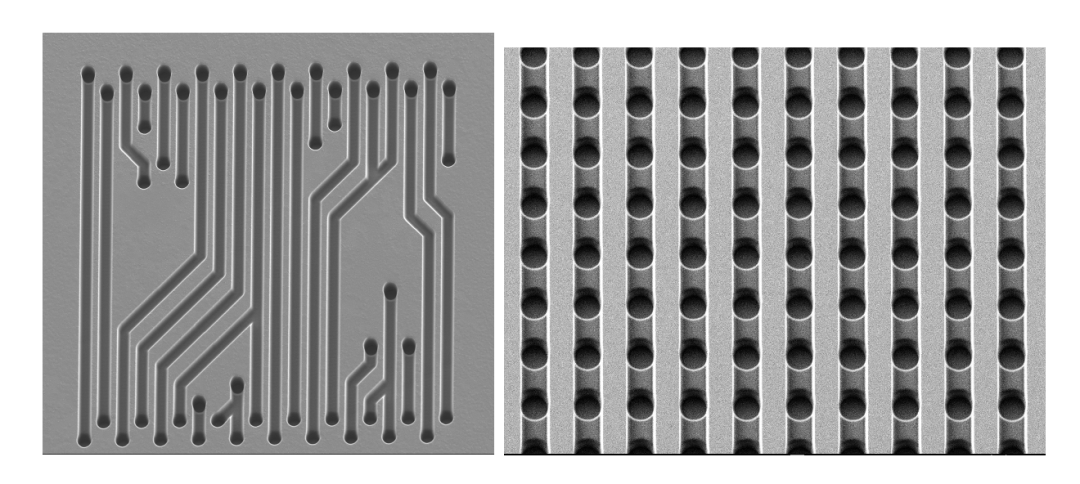
图 无掩模光刻技术展示了同时对重新分布层(左)和过孔层(右)进行图形化的能力
对于追求极致线宽、进行大规模量产的半导体前道制造而言,以EUV为代表的、配合复杂RETs的传统掩模光刻仍是不可替代的主流。然而,在更广阔的科研、教育、先进封装、MEMS、生物芯片等领域,对研发效率、成本控制和设计灵活性的要求,往往超越了对极限分辨率的单一追求。
在这些场景下,以泽攸科技DMD光刻机为代表的无掩模技术,通过将光刻过程从依赖昂贵物理模板的“重资产”模式,转变为由软件定义的“轻量化”数字流程,为工程师和科研人员提供了一种高效、经济且功能强大的新工具。它让微纳加工不再是少数尖端实验室的专利,而是成为更多创新思想得以快速验证和实现的平台。最终技术的选择并非简单的优劣之分,而是在深刻理解其物理边界和工程特性的基础上,针对具体应用需求所做出的最明智的权衡。
参考资料
1、N. Takahashi, H. Kikuchi. “Rayleigh Criterion: The Paradigm of Photolithography Equipment.” Annals of Business Administrative Science 147 1 (2017): 203–213.
2、Liu, Junbo, et al. “The Inverse Optimization of Lithographic Source and Mask via GA-APSO Hybrid Algorithm.” Photonics, vol. 10, no. 6, June 2023, p. 638. Crossref,.
3、“The Rayleigh Criterion for Resolution.” ASML.
4、维基百科:角分辨率、沉浸光刻、Phase-shift mask、Optical proximity correction
5、Levinson, H. “Immersion Lithography and the Limits of Optical Lithography.” 2011. 0.
6、Mack, Chris A. “Resolution Enhancement Technologies.” The Lithography Expert, May 2003, Tutor41.doc, Version 12/9/03.
7、Yu, Haoyang, et al. “Optical Encryption by Dynamically Modulating the Spatial Frequency of Light Fields.” Optics Communications, vol. 560, June 2024, p. 130459. Crossref.
8、Derbyshire, Katherine. “Is Maskless Lithography Coming Into Its Own?” Semiconductor Engineering, 17 Aug. 2023.
作者:泽攸科技
